离子注入中,BF2和B注入有什么差异?
在半导体制造领域,离子注入作为一项关键技术,通过将特定离子加速并引入目标材料,精准地改变材料的物理、化学或电学特性。其中,硼(B)及其化合物离子注入在调节半导体电学性能方面发挥着重要作用,BF₂和 B 注入在实际应用中展现出诸多差异。
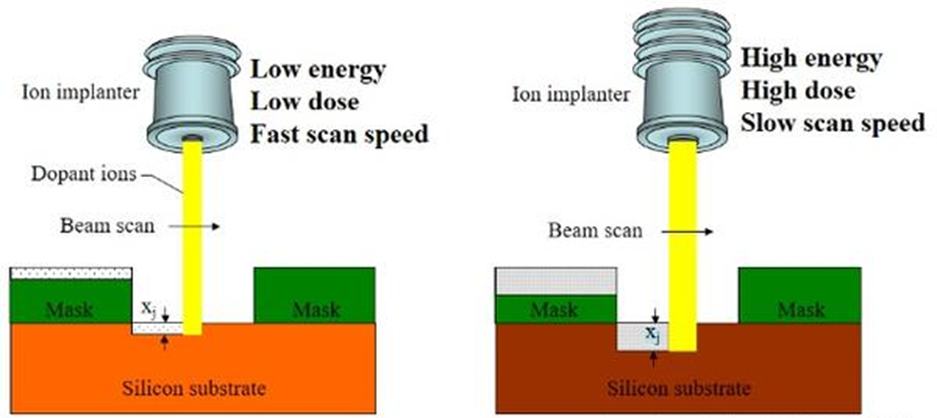
从离子源特性来看:
B 离子注入相对直接,源物质主要为硼元素相关材料,如硼烷等,电离后直接形成 B 离子束。而 BF₂离子注入的离子源更为复杂,需使用含 BF₃等化合物的气体,通过电离产生 BF₂离子。这一差异使得离子源的设计、维护及离子产生效率有所不同,BF₂离子源由于涉及多原子离子的产生,在保证离子纯度和稳定性方面面临更大挑战。
注入过程中,二者在离子穿透能力上表现出明显区别:
由于 BF₂离子质量比 B 离子大,在相同注入能量下,BF₂离子的速度相对较慢,穿透深度较浅。根据离子射程理论,离子穿透深度与离子质量、能量以及靶材料性质相关。例如在硅基半导体中,同等注入能量为 100keV 时,B 离子的平均穿透深度可达数十纳米,而 BF₂离子的穿透深度可能仅为十几纳米。这种穿透深度的差异决定了它们在不同半导体结构中的应用场景,B 离子更适合需要较深掺杂的情况,如形成深阱区;BF₂离子则常用于浅结制造,以满足超大规模集成电路中对浅表层精确掺杂的需求。
BF₂离子注入最大的优点是形成浅结,这是基于质量分配假设: BF₂离子注入时,不同粒子得到的能量与其质量成正比,B原子质量数为10.8,BF2分子质量数为 48.8,二者之比为 0.22,当 BF₂离子注入能量为90Kev时,B离子分得的能量为19.8Kev=90*0.22),这样可以在较高的注入能量下,得到低能量B离子注入的效果。当然也可以直接作低能量的B离子注入,但这样束流太小,故一般不采用。
注入后对半导体材料的影响也存在差异:
B 离子注入后,直接作为三价杂质原子,在硅晶格中替代硅原子位置,形成 P 型半导体特性,其引入的空穴载流子浓度与注入剂量直接相关。而 BF₂离子注入后,除了硼原子贡献掺杂效果外,氟原子的存在会对半导体晶格产生额外影响。氟原子具有较强的电负性,它可以与硅原子形成化学键,起到钝化晶格缺陷的作用,减少载流子散射,一定程度上提高载流子迁移率。在一些先进半导体工艺中,利用 BF₂离子注入来改善器件的电学性能,特别是在对载流子迁移率要求较高的晶体管制造中。
从工艺成本角度考虑,BF₂离子注入由于其离子源复杂、对设备要求更高,且在注入过程中需要更精确的控制以确保 BF₂离子的完整性,所以总体工艺成本相对较高。而 B 离子注入工艺相对简单,成本较为低廉。这使得在满足性能要求的前提下,B 离子注入在一些对成本敏感的应用场景中更具优势,而 BF₂离子注入则用于对性能有严苛要求、愿意承受较高成本的高端半导体制造。
总结:
在半导体制造中,BF₂和 B 离子注入在离子源特性、穿透深度、对材料影响及工艺成本等方面存在显著差异,工程师需根据具体的器件设计要求和工艺目标,合理选择合适的离子注入方式,以实现最优的半导体性能和经济效益。
在线留言询价
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| RB751G-40T2R | ROHM Semiconductor | |
| CDZVT2R20B | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| TL431ACLPR | Texas Instruments | |
| BD71847AMWV-E2 | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| TPS63050YFFR | Texas Instruments | |
| BP3621 | ROHM Semiconductor | |
| BU33JA2MNVX-CTL | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:






















