电子元器件的封装是什么意思 封装的作用及内容
封装就是他的封装形式,都有一些固定的封装尺寸。这个便于电路图的设计,印制电路板时要规定每个元器件的封装,这样最后电路元器件才能刚好吻合匹配在电路板的相对位置。
封装的主要作用有:
(1)物理保护
因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降,保护芯片表面以及连接引线等,使相当柔嫩的芯片在电气或热物理等方面免受外力损害及外部环境的影响;同时通过封装使芯片的热膨胀系数与框架或基板的热膨胀系数相匹配,这样就能缓解由于热等外部环境的变化而产生的应力以及由于芯片发热而产生的应力,从而可防止芯片损坏失效。基于散热的要求,封装越薄越好,当芯片功耗大于2W时,在封装上需要增加散热片或热沉片,以增强其散热冷却功能;5~1OW时必须采取强制冷却手段。另一方面,封装后的芯片也更便于安装和运输。
(2)电气连接
封装的尺寸调整(间距变换)功能可由芯片的极细引线间距,调整到实装基板的尺寸间距,从而便于实装操作。例如从以亚微米(目前已达到0.13μm以下)为特征尺寸的芯片,到以10μm为单位的芯片焊点,再到以100μm为单位的外部引脚,最后剑以毫米为单位的印刷电路板,都是通过封装米实现的。封装在这里起着由小到大、由难到易、由复杂到简单的变换作用,从而可使操作费用及材料费用降低,而且能提高工作效率和可靠性,特别是通过实现布线长度和阻抗配比尽可能地降低连接电阻,寄生电容和电感来保证正确的信号波形和传输速度。
(3)标准规格化
规格通用功能是指封装的尺寸、形状、引脚数量、间距、长度等有标准规格,既便于加工,又便于与印刷电路板相配合,相关的生产线及生产设备都具有通用性。这对于封装用户、电路板厂家、半导体厂家都很方便,而且便于标准化。相比之下,裸芯片实装及倒装目前尚不具备这方面的优势。由于组装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的印刷电路板(PCB)的设计和制造,对于很多集成电路产品而言,组装技术都是非常关键的一环。
芯片的封装技术已经历了好几代的变迁,从DIP,QFP,PGA,BGA,到CSP再到MCM,技术指标一代比一代先进,包括芯片面积与封装面积之比越来越接近于1,适用频率越来越高,耐温性能越来越好。引脚数增多,引脚间距减小,重量减小,可靠性提高,使用更加方便等等。
封装的内容
(1)通过一定的结构设计、工艺设计、电设计、热设计和可靠性设计制造出合格的外壳或引线框架等主要零部件;
(2)改进封装结构、确定外形尺寸,使之达到通用化、标准化,并向多层次、窄节距、多引线、小外形和高密度方向发展;
(3)保证自硅晶圆的减薄、划片和分片开始,直到芯片粘接、引线键合和封盖等一系列封装所需工艺的正确实施,达到一定的规模化和自动化;
(4)在原有的材料基础上,提供低介电系数、高导热、高机械强度等性能优越的新型有机、无机和金属材料;
(5)提供准确的检验测试数据,为提高集成电路封装的性能和可靠性提供有力的保证。
封装(Package)对于芯片来说是必须的,也是至关重要的。封装也可以说是指安装半导体集成电路芯片用的外壳,它不仅起着保护芯片和增强导热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁和规格通用功能的作用。
上一篇:传感器工作原理及种类介绍
下一篇:半导体元器件是怎样制造出来的
在线留言询价
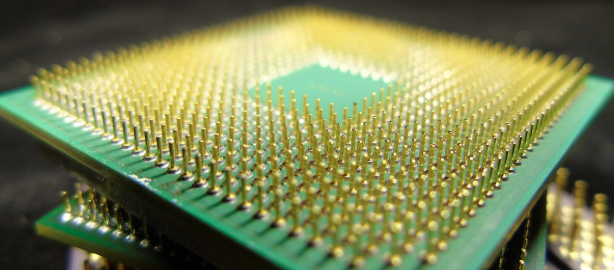
一文了解芯片BGA封装的工艺流程
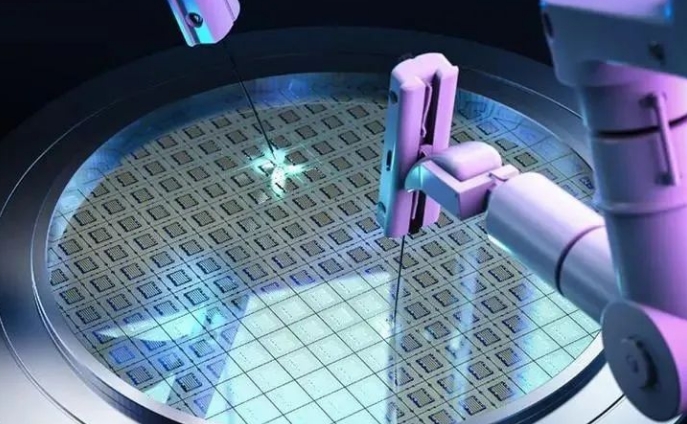
掩膜版在先进封装中的应用

引线框架对半导体器件性能与可靠性的影响
- 一周热料
- 紧缺物料秒杀
| 型号 | 品牌 | 询价 |
|---|---|---|
| RB751G-40T2R | ROHM Semiconductor | |
| MC33074DR2G | onsemi | |
| BD71847AMWV-E2 | ROHM Semiconductor | |
| TL431ACLPR | Texas Instruments | |
| CDZVT2R20B | ROHM Semiconductor |
| 型号 | 品牌 | 抢购 |
|---|---|---|
| ESR03EZPJ151 | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| TPS63050YFFR | Texas Instruments | |
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| BP3621 | ROHM Semiconductor |
AMEYA360公众号二维码
识别二维码,即可关注


请输入下方图片中的验证码:























