- Ameya360 Component Supply Platform >
- Trade news >
- 引线框架对半导体器件性能与可靠性的影响
引线框架对半导体器件性能与可靠性的影响
一、什么是引线框架?
引线框架(Lead Frame)是一种金属结构,主要用于半导体芯片的封装中,作用就像桥梁——它连接芯片内部的电信号到外部电路,实现电气连接,同时还承担机械支撑和散热任务。它广泛应用于中低引脚数的封装形式中,比如DIP、QFP、SOP、DFN等,是半导体封装的基础材料之一。

二、引线框架对半导体的三大关键影响
1. 影响电气性能
导电路径:引线框架上的引脚负责把芯片信号传输到外部PCB。其尺寸(厚度、宽度)会影响电阻,进而影响电源电压降和信号完整性。
寄生参数:不合理的引脚布局会引入寄生电感、电容,影响高速信号传输,尤其在射频、电源管理、接口电路中更为显著。
设计一致性:引脚长度/间距的不均可能导致信号延迟差异,影响时序匹配。
电源完整性(Power Integrity):地线和电源引脚布局设计不合理,会带来噪声、压降和干扰问题。
2. 影响热管理能力
散热效率:高导热金属(如Cu、Cu合金)制成的引线框架可迅速把芯片产生的热量传导出去,降低芯片核心温度。
结构设计:通过设计暴露焊盘(Expose Pad)或厚铜结构可提升散热路径,适用于高功率器件如MOSFET、功放、LED驱动等。
封装集成度越高,芯片越容易发热,对引线框架的散热能力提出更高要求。
3. 影响器件可靠性
机械可靠性:引线框架与封装材料(如EMC)之间必须有良好的附着力,防止长期使用后出现分层、开裂。
防潮抗氧化能力:若表面处理不当,水汽可能沿引线框架渗透,引起芯片失效。优质框架通常采用镀NiPdAu或SnAgCu等防氧层。
应力控制:在冷热循环或高应力条件下,不同材料间热膨胀系数差异会产生应力,若结构设计或选材不当,可能导致封装开裂或焊点失效。
三、随着半导体发展,引线框架面临的挑战也更大
小型化:芯片功能变多、体积更小,引线数越来越多,引脚间距越来越密(如130μm以内),制造精度要求高。
多样化:封装形式日益丰富(如QFN、DFN、DROFN等),引线框架设计也需高度定制化。
高可靠性要求:应用从消费电子转向汽车、工业、新能源等领域,对产品寿命、抗湿、抗高温等提出更严格要求。
先进工艺需求:包括选择性电镀、表面粗化、微结构蚀刻、湿度敏感等级MSL1要求等。
四、结语:引线框架的不可替代性
作为芯片与电路板之间的桥梁,引线框架不只是一个“金属支架”,它在电性能、热性能和可靠性三方面都发挥着关键作用。尤其是在汽车、工业、新能源等领域,它的作用越来越重要。未来引线框架的发展也将继续跟随芯片制程演进向更高密度、更高可靠、更低成本的方向推进。
换句话说:一个优秀的封装,必须有一个强大而精密的引线框架作为基础。
Previous:帝奥微:超低漏电的高速开关DIO3749
Online messageinquiry
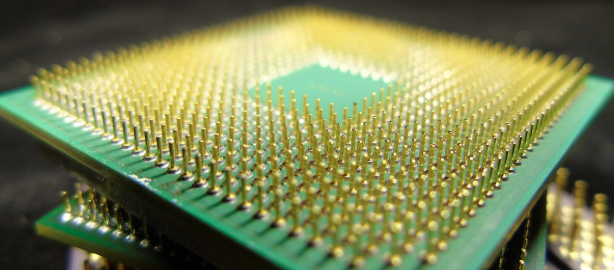
一文了解芯片BGA封装的工艺流程
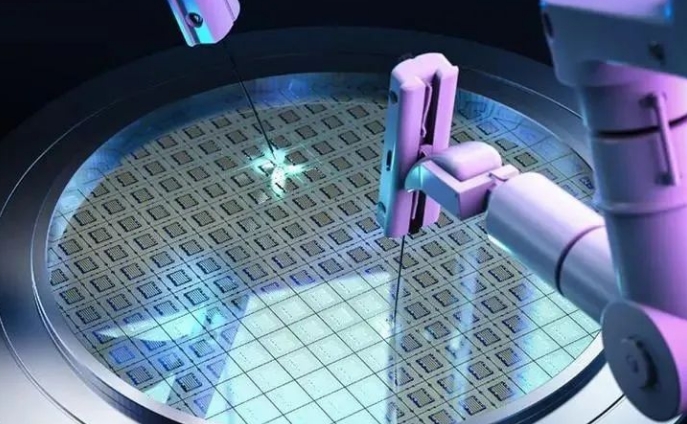
掩膜版在先进封装中的应用
- Week of hot material
- Material in short supply seckilling
| model | brand | Quote |
|---|---|---|
| TL431ACLPR | Texas Instruments | |
| MC33074DR2G | onsemi | |
| CDZVT2R20B | ROHM Semiconductor | |
| RB751G-40T2R | ROHM Semiconductor | |
| BD71847AMWV-E2 | ROHM Semiconductor |
| model | brand | To snap up |
|---|---|---|
| BU33JA2MNVX-CTL | ROHM Semiconductor | |
| STM32F429IGT6 | STMicroelectronics | |
| BP3621 | ROHM Semiconductor | |
| IPZ40N04S5L4R8ATMA1 | Infineon Technologies | |
| ESR03EZPJ151 | ROHM Semiconductor | |
| TPS63050YFFR | Texas Instruments |
Qr code of ameya360 official account
Identify TWO-DIMENSIONAL code, you can pay attention to


Please enter the verification code in the image below:






















